LPCVD Low-Pressure Chemical Vapor Deposition Equipment
The LPCVD low-pressure chemical vapor deposition equipment (research-oriented LPCVD) deposits various functional thin films—primarily Si3N4, SiO2, and polysilicon films—onto substrates via chemical reaction-based vapor-phase epitaxy under low-pressure and high-temperature conditions. It can be used for scientific research, practical teaching, and small-scale device fabrication.
- Product Description
-
LPCVD Low-Pressure Chemical Vapor Deposition Equipment (Research-Grade LPCVD) Under low-pressure and high-temperature conditions, various functional thin films (primarily Si) are deposited onto a substrate via chemical vapor deposition. 3 N 4 , SiO 2 and poly-silicon thin films. It can be used for scientific research, practical teaching, and the fabrication of small-scale devices.
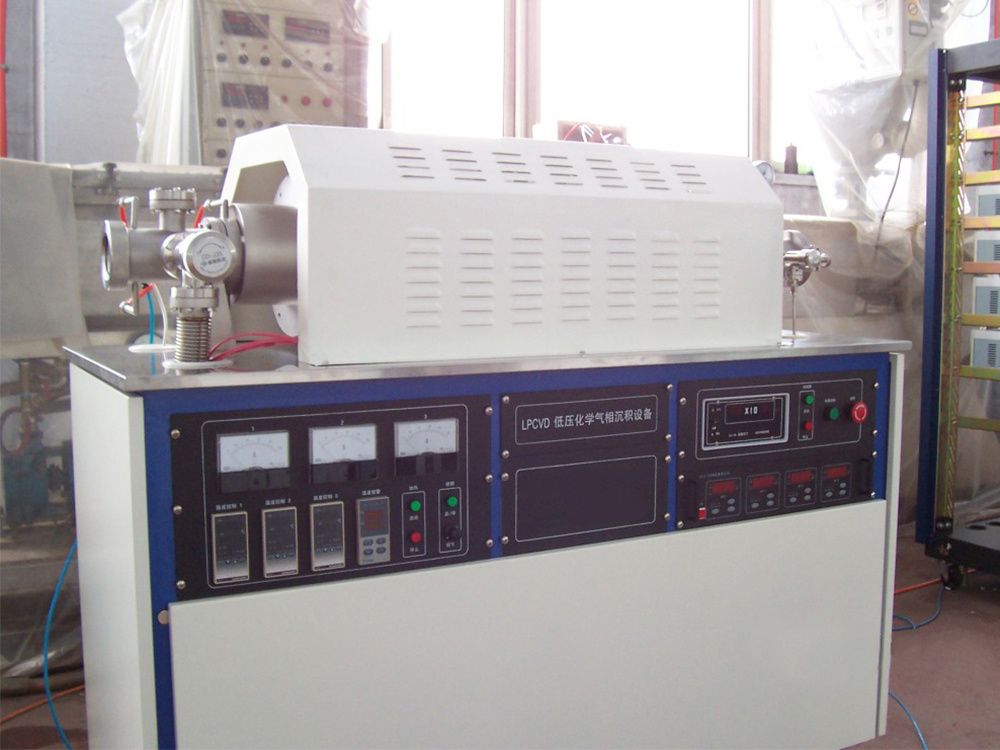
Equipment Structure and Features
1. Miniaturization for convenient laboratory operation and use, significantly reducing experimental costs.
Two substrate sizes—2 inches or 4 inches—each batch can hold 1 to 3 wafers.
Substrate placement methods: Three types of substrate holders are provided—vertical, horizontal lying, and tilted.
Substrate shape types: Irregular-shaped loose pieces, standard substrates with diameters ranging from 2 to 4 inches.
2. The equipment features a horizontal, tube-type,卧式 structure.
It consists of a quartz tube reaction chamber, an insulated furnace enclosure cabinet, an electrical control system, a vacuum system, a gas pipeline system, a temperature control system, a pressure control system, and a cylinder cabinet, among other systems.
The reaction chamber is made of high-purity quartz, which offers excellent corrosion resistance, anti-contamination properties, low leakage rates, and is suitable for high-temperature applications. The equipment’s electrical control system features advanced detection and control technologies, ensuring accurate measurement values and stable, reliable performance.3. The system provides an automatic control dust-free device.

Main Technical Specifications of LPCVD Equipment
LPCVD Low-Pressure Chemical Vapor Deposition Equipment (Production-Grade LPCVD)Type
Parameter
Film-forming type
Yes 3 N 4 Poly-Si, SiO 2 Wait
Highest temperature
1200℃
Constant temperature zone length
Configure according to user needs.
Temperature control accuracy in the constant-temperature zone
≤ ±0.5℃
Working pressure range
13–1330 Pa
Film layer non-uniformity
≤±5%
Number of substrates loaded each time
Standard substrates: 1–3 pieces; irregularly sized loose pieces: several.
Stress control
Closed-loop inflatable control
Slide mounting method
Manual sample loading and unloading
Device Function
This device employs chemical vapor deposition under low-pressure, high-temperature conditions to deposit various functional thin films—primarily Si—onto a substrate. 3 N 4 , SiO 2 and poly-silicon thin films).
Relevant coating processes are available.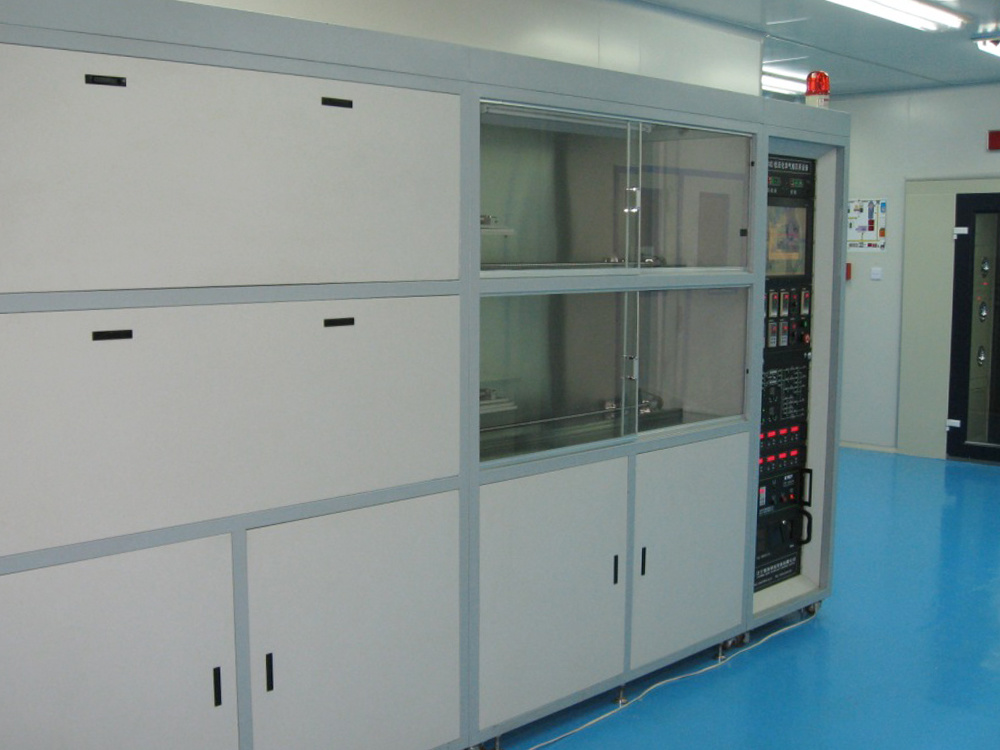
Equipment Structure and Features:
The equipment features a horizontal, tube-type, lying-down structure and consists of systems including a quartz-tube reaction chamber, an insulated furnace enclosure cabinet, an electrical control system, a vacuum system, a gas pipeline system, a temperature control system, a pressure control system, and a cylinder cabinet.
The reaction chamber is made of high-purity quartz, which offers excellent corrosion resistance, anti-contamination properties, low leakage rates, and is suitable for high-temperature applications. The equipment’s electrical control system features advanced detection and control technologies, ensuring accurate measurement values and stable, reliable performance.
The entire process is managed by a computer that oversees the entire process flow, enabling monitoring and automatic control of process parameters such as furnace temperature, gas flow rate, pressure, valve operations, and pump on/off. Manual control is also available.
Main Technical Specifications of the Equipment
LPCVD Software Control InterfaceType
Parameter
Film-forming type
Yes 3 N 4 Poly-Si, SiO 2 Wait
Highest temperature
1200℃
Constant temperature zone length
Configure according to user needs.
Temperature control accuracy in the constant-temperature zone
≤ ±0.5℃
Working pressure range
13–1330 Pa
Film layer non-uniformity
≤±5%
Number of substrates loaded each time
100 pieces
Total device power
16 kW
Cooling water consumption
2m3 /h
Stress control
Closed-loop inflatable control
Slide mounting method
Cantilever boat automatic sample delivery

LPCVD Manual Operation Interface
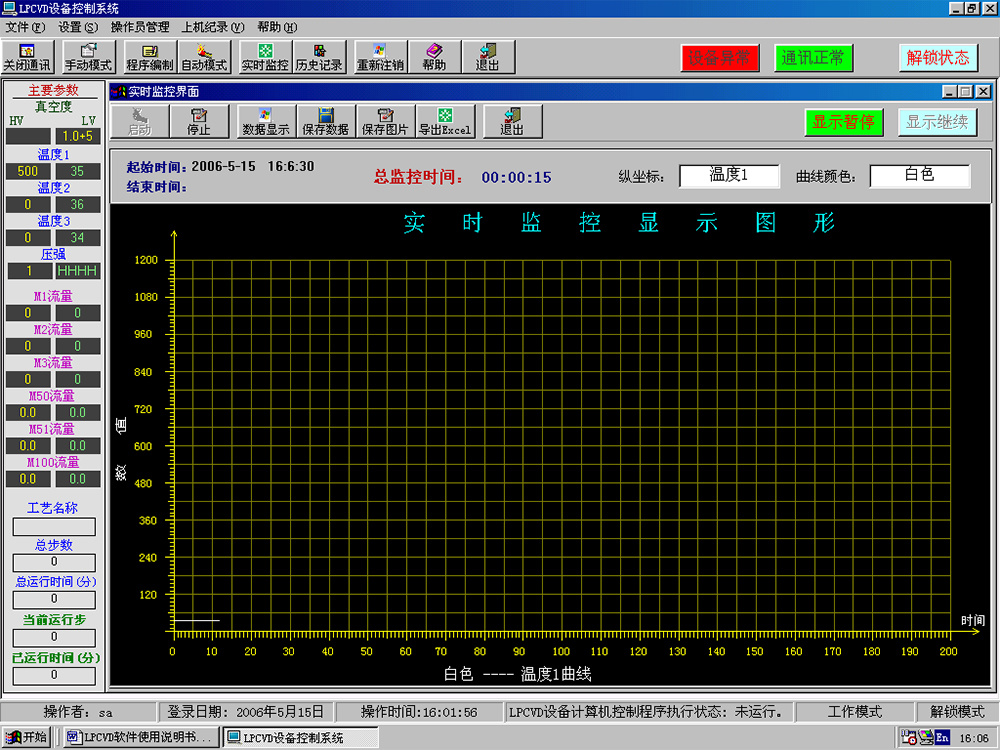
LPCVD Real-Time Operation Monitoring Interface

LPCVD Automatic Operation Interface

LPCVD Process Interface Development
Keywords:
Get a quote
Related products









